《電零組》「雙均熱片」扮台積3D封裝良率要角 健策業績添動能
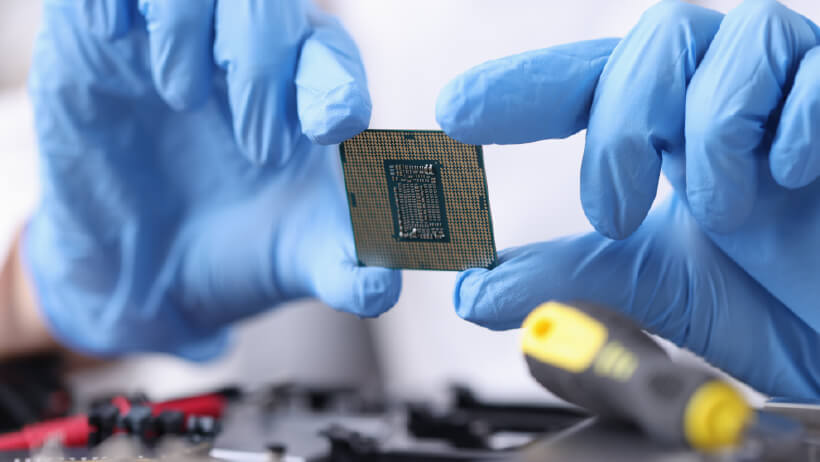
(圖片來源:freepik)
發布時間:2026-04-28 10:15:21
分享
作者:時報新聞
【時報記者張漢綺台北報導】半導體先進3D封裝熱功耗急遽攀升,健策(3653)開發結合均熱片與Stiffener(加強筋/補強板)功能的「雙片式均熱片」產品,有效解決散熱與熱變形問題,成為台積電(2330)提升3D封裝良率的關鍵要角,隨著「雙片式均熱片」產品於今年下半年開始投產,可望為健策營運增添新動能。 台積電的CoWoS技術已推進至第三代,SoIC則進入第二代,但先進封裝技術演進讓散熱更趨複雜,台積電與記憶體、基板、測試設備、材料及OSAT夥伴緊密結盟,共同解決複雜封裝帶來的翹曲(Warpage)與散熱(Thermal Dissipation)等物理挑戰,在此次台積電北美技術論壇,將健策(Jentech)被明確歸類於SMD/LID/TIM(被動元件/均熱片/散熱材料)領域生態系統中的重要合作夥伴。 健策在台積電3DFabric提供全方位解決方案(Total Solution),健策表示,隨著多顆Chiplet(小晶片)與高頻寬記憶體(HBM)透過 CoWoS或SoIC緊密整合,單位面積的熱功耗急遽上升,且在3D封裝過程中,不同材質的熱膨脹係數差異極易導致晶片翹曲(Warpage),這也是台積電特別點出的挑戰,健策專精的精密金屬加工與均熱片(Lids)技術,提供的高品質均熱片不僅用於導熱,更作為高強度的機械結構件,幫助大面積封裝維持平整度,正是解決高階GPU與AI運算基礎設施散熱瓶頸的關鍵,負責將晶片運作時的龐大熱能有效導出,從而協助台積電提升整體良率。 此外,面對CoWoS與SoIC高達80%~90%的年複合成長率,台積電需要極度品質穩定且具備大規模量產能力的供應商,健策具備高精度金屬沖壓與自動化大量量產的成本與產能優勢,能夠即時響應台積電急速擴大的材料需求,是台積電實現「加速產品上市(Time-to-Market)」承諾關鍵要角。
☞警語:以上媒體報導,非任何形式之投資建議,投資前請獨立思考、審慎評估。nStock網站所有內容僅供APP使用教學參考,並無任何推介買賣之意,投資人應自行承擔交易風險。
每日補充新知識
熱門排行
上市
上櫃
合併
漲幅
跌幅
成交值
讀取中....
