《產業》台積北美技術論壇登場 創意、世芯秀肌肉 AI ASIC、HBM4競速
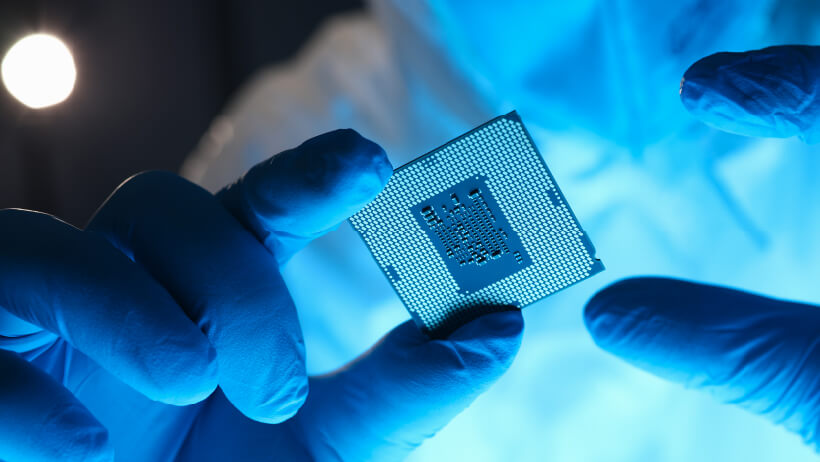
(圖片來源:freepik)
發布時間:2026-04-23 08:46:56
分享
作者:時報新聞
【時報-台北電】台積電 2026 北美技術論壇 22 日在美國聖塔克拉拉登場,合作夥伴展區再度成為先進製程、先進封裝與高速互連技術競逐焦點。其中,創意電子(3443)展示採用台積電 3 奈米製程實現的 12Gbps HBM4 IP 平台;世芯-KY(3661)則主打 2 奈米生態系準備度、3DIC 整合能力與先進封裝實績,凸顯 AI ASIC 戰場正從單一晶片效能,進一步延伸至 HBM、Chiplet 與 2.5D/3D 封裝整體平台競爭。 創意指出,此次展示的 HBM4 IP 平台整合自研 HBM4 Controller 與 PHY,並搭配合作夥伴的 HBM4 記憶體與台積電 CoWoS 先進封裝技術。以規格來看,創意前一代 HBM3E PHY 與控制器已導入客戶 3 奈米產品,量產實測效能高於規格 15%;新一代 HBM4 IP 相較 HBM3E 可提供 2.5 倍頻寬,功耗效率提升 1.5 倍、面積效率提升 2 倍,顯示高速記憶體介面已成 AI 晶片設計兵家必爭之地。 更值得注意的是,創意這次不只強調 HBM4 本身,也進一步把產品定位拉高到 3D IC 架構。公司表示,HBM4 PHY 支援 face-up 配置,可整合至台積電 SoIC face-to-face 架構,並在設計中納入 TSV,以支援 I/O、電源與接地連接,同時預留額外 TSV 作為上層晶片供電穿透,鎖定未來多晶粒、堆疊式 AI 運算平台需求。這意味創意正從傳統 ASIC 設計服務,向高速介面 IP 與先進封裝整合平台供應商邁進。 創意並指出,該 HBM4 IP 也整合 proteanTecs 的互連監測技術,以提升 PHY 測試與特性分析可視性,強化終端產品實際運行時的效能與可靠度。創意技術長 Igor Elkanovich 也在活動中表示,創意是首家在 TSMC 技術論壇向客戶展示 12Gbps HBM4 IP 的公司,若再結合 UCIe 與 GLink-3D IP,可望補齊 SoIC-X on CoWoS 所需的 2.5D/3D IP 解決方案。 另一方面,世芯-KY 在同場論壇則把焦點放在 AI 與 HPC ASIC 的製程、封裝與 Chiplet 能力延伸。根據公司對外資訊,世芯已具備 3 奈米量產設計經驗,並建立 2 奈米生態系支援下一代 AI 處理器,同時展示完整 3DIC 設計平台與多項開發計畫,涵蓋 3 奈米 I/O chiplet、高速光互連技術,以及其他先進節點測試晶片開發。 在封裝面,世芯強調其量產經驗已涵蓋 CoWoS-R、CoWoS-S,並進一步延伸至 CoWoS-L 與 SoIC-X 實作,凸顯公司在 AI 晶片大型化、記憶體堆疊化與 Chiplet 化浪潮下,持續強化後段整合能力。若對照台積電今年論壇主軸從電晶體微縮延伸到系統整合,可看出 AI 晶片競賽已從「誰先採用先進製程」,進一步升級為「誰能更快把 HBM、Chiplet、3DIC 與先進封裝整合成可量產平台」。(新聞來源:工商即時 張珈睿)
☞警語:以上媒體報導,非任何形式之投資建議,投資前請獨立思考、審慎評估。nStock網站所有內容僅供APP使用教學參考,並無任何推介買賣之意,投資人應自行承擔交易風險。
今日大漲股
熱門排行
上市
上櫃
合併
漲幅
跌幅
成交值
讀取中....
